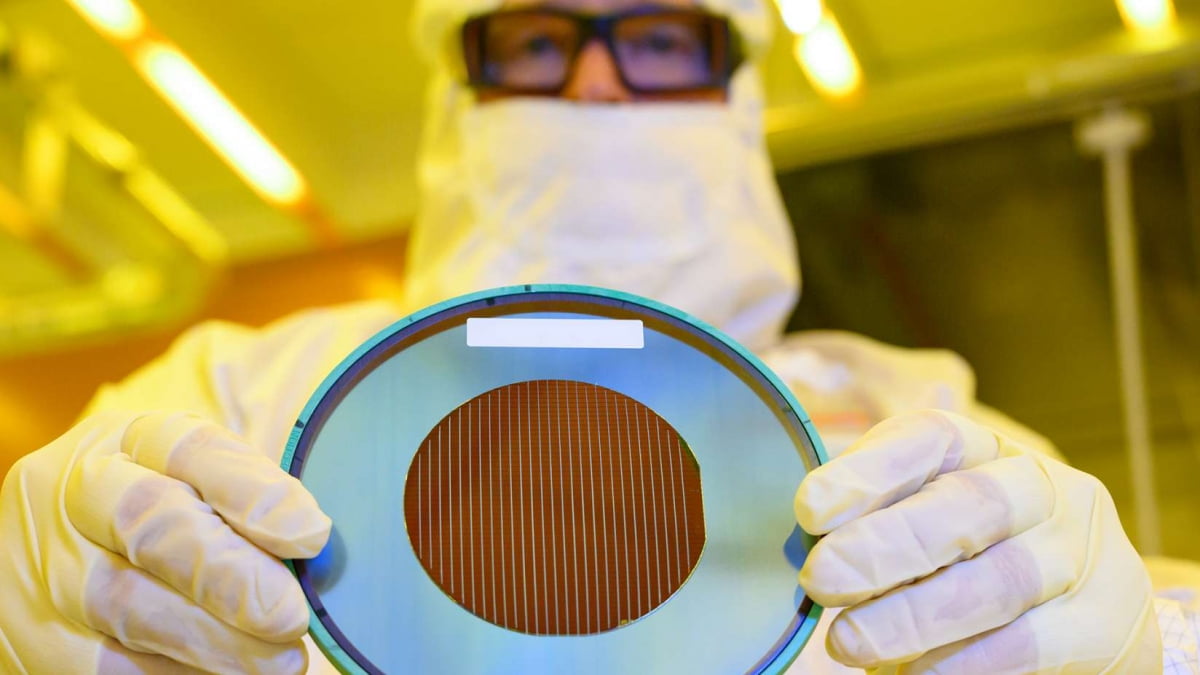
TSMC, 삼성전자, 인텔. '파운드리 빅3'가 최근 최첨단 패키징(advanced packaging)에서 본격적인 경쟁을 시작했다. 최첨단 패키징은 이종(異種) 칩을 쌓거나 수평으로 배치해 하나의 반도체처럼 작동하게 하는 후(後)공정이다. 칩을 작게 만들어 성능을 높이는 ‘초미세공정’에 한계가 오면서 반도체 기업들은 최근 최첨단 패키징을 통한 성능 극대화에 주력하고 있다. 한 칩에 여러 기능을 넣어 한 번에 만드는 것보다 각각의 칩을 최적의 공정에서 만들고 패키징하는 게 비용 측면에서도 유리하다. 생성형 인공지능(AI)의 필수재로 꼽히는 엔비디아의 'H100' 같은 'AI 가속기'가 최첨단 패키징을 활용해 생산된 제품이다
현재 최첨단 패키징 시장 점유율은 집계·공표되지 않고 있다. 업계에선 TSMC가 최첨단 패키징 브랜드인 'CoWoS(칩은 웨이퍼 온 서브 스트레이트)'를 앞세워 시장을 주도하고 있는 것으로 평가한다. CoWoS는 '인터포저'(칩과 기판을 전기적으로 연결하는 층) 위에 CPU(중앙처리장치), GPU(그래픽처리장치) 같은 시스템반도체와 D램을 수직으로 쌓은 고대역폭메모리(HBM)를 배치해 작동하게 하는 '2.5D 패키징'의 일종이다. TSMC는 CoWos를 활용해 엔비디아의 H100 가속기를 생산한다. 엔비디아의 GPU와 SK하이닉스의 HBM3를 CoWoS를 통해 연결하는 것이다.
TSMC는 2.5D보다 한 단계 진화한 것으로 평가되는 '3D 패키징'의 핵심인 'SoIC'에도 투자를 아끼지 않고 있다. 3D패키징은 다른 칩을 수평으로 배치하는 게 아니라 수직으로 쌓아서 성능을 높이는 기술이다. TSMC의 SoIC는 칩들을 기존 패키징보다 가까이 붙여 데이터 전송 속도를 높인 게 특징으로 꼽힌다.
TSMC는 올해 최첨단 패키징에 대규모 투자를 예고했다. TSMC는 최근 실적설명회에서 올해 시설투자(CAPEX) 예정액으로 280억~320억달러(37조~42조원)를 제시했다. 이 중 10%인 최대 32억달러(약 4조2000억원)를 최첨단 패키징에 투자할 계획이다. 파운드리 가동률 저하에 대한 우려가 커지고 있지만 지난해 투자액 추정치(32억달러) 수준을 유지한 것이다

포베로스는 인텔의 주력 제품인 CPU에 적용되고 있다. 예컨대 인텔의 PC용 CPU인 '메테오레이크'는 인텔의 기본 타일 위에 자사 4nm 공정에서 양산한 CPU, TSMC 5nm 공정에서 생산한 GPU, TSMC 6nm 공정에서 만든 입출력(I/O) 단자를 수직으로 패키징한 제품이다. 인텔은 지난해 최첨단 패키징에 TSMC와 같은 32억달러를 투자한 것으로 알려졌다
삼성전자는 이미 'I-CUBE'란 2.5D 패키징 브랜드를 갖고 있다. 삼성전자는 I-Cube에 대해 AI 반도체에 많이 쓰이는 CPU 또는 GPU 간의 칩렛(Chiplet) 연결이나 AI 가속기와 HBM를 수평으로 배치해 하나의 반도체처럼 동작하게 하는 기술이라고 소개한다. 삼성전자는 파운드리에서 양산한 칩에 최첨단 패키징까지 제공하는 '턴키 서비스'를 제공 중이다.
3D 패키징도 본격화한다. 'X-CUBE' 브랜드를 이미 내놨다. 웨이퍼(반도체 원판) 상태의 복수의 반도체를 위로 얇게 적층하는 기술이다. 서로 다른 반도체를 수직으로 적층해 기존 패키지에 비해 연결선의 길이를 줄여 성능을 높이고, 반도체 패키지의 크기를 줄일 수 있는 것이 장점으로 꼽힌다. 2026년에는 칩 간의 연결통로의 일종인 '범프'를 없애고 대신 구리로 접착시키는 하이브리드 본딩을 활용한 '범프리스 X-Cube'를 선보일 계획이다.
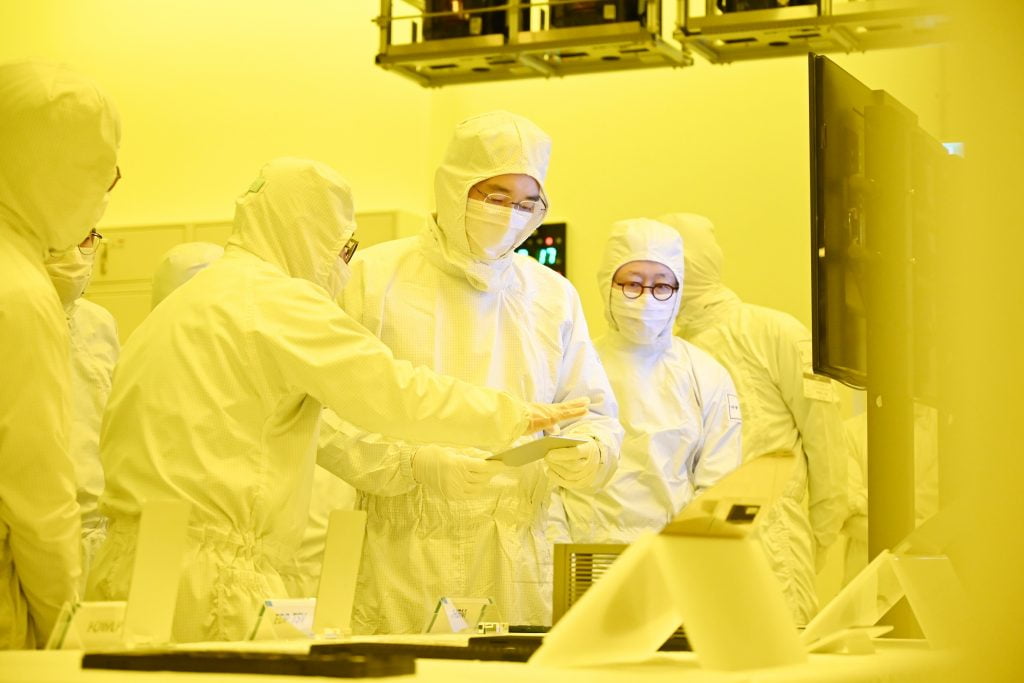
삼성전자는 임시 데이터 저장소 역할을 하는 S램을 중앙처리장치(CPU) 등 프로세서 위에 쌓는 ‘SAINT-S’의 기술 검증을 완료했다. 올해엔 CPU, 그래픽처리장치(GPU) 등의 프로세서 위에 데이터 저장용 D램을 올리는 ‘SAINT-D’, 애플리케이션프로세서(AP) 같은 프로세서를 위아래로 배치하는 ‘SAINT-L’의 기술 검증을 마칠 계획인 것으로 알려졌다.
인력 지키기와 충원을 위한 방안도 마련 중이다. 삼성전자는 최첨단 패키징을 담당하는 AVP사업팀 개발 담당 직원들의 근무지를 충남 천안에서 경기 화성·용인으로 옮기는 방안을 추진 중이다. 시점은 연말께가 거론된다.
황정수 기자 hjs@hankyung.com
관련뉴스
















